概要
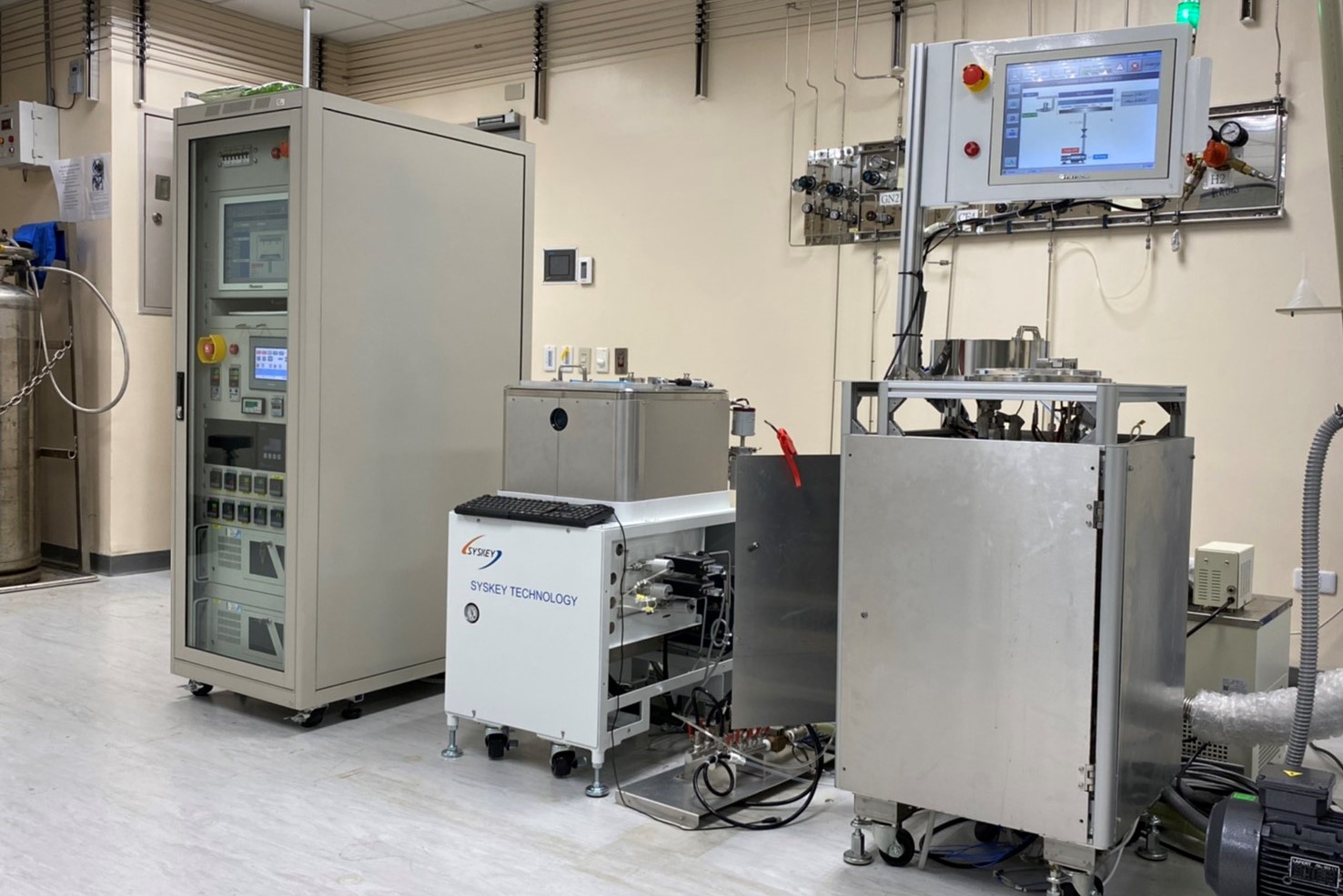
本中心的設備主要協助同仁進行生醫影像觀測、材料表面分析、元件結構製作及精密樣品製程等研究,分布在跨領域科技研究大樓(以下簡稱為IRBST)六樓、四樓及地下二樓。除了核心設施,中心在六樓、四樓及地下二樓亦有公用實驗室,可配合同仁進行相關製程、影像、細胞及蛋白質研究。
本中心設施按照功能可分為三大類型:高解析顯微鏡、樣品分析、微奈米製程。
| 類型 | 儀器 | 功能 | 廠牌 | 位置 |
|---|---|---|---|---|
| 高解析度顯微鏡 | 原子力顯微鏡 | 材料表面分析 | Bruker DM-CAFM | 陽明交通大學 田家炳光電中心 506室 |
| 快速雷射掃描共軛焦分光光譜顯微鏡 | 生物暨螢光樣品量測 | Leica TCS-SP5 | IRBST 4B20 | |
| 液相原子力顯微鏡 | 奈米材料或元件液態檢測 | JPK Nano Wizard II & III | IRBST B2C01 | |
| 顯微拉曼光譜儀 | 材料螢光及結晶特性分析 | Jobin Yvon HR800 | IRBST 6B08 | |
| 場發射高低真空高解析度掃描式電子顯微鏡 | 表面結構與元素分析 | Nova 200 NPE 44/D8187 | IRBST 4C05 | |
| 樣品分析 | X 光光電子光譜儀 | 表面與縱深元素分析 | ULVAC-PHI PHI-5000 Versaprobe | IRBST 4C05 |
| 掃描式離子顯微鏡 | 表面與縱深元素與分子分析 | ULVAC-PAI TRIFTV | IRBST 4C05 | |
| 皮秒時間相關單分子螢光顯微光譜儀 | 多通道的時間解析光譜系統 | PicoQuant Micro Time 2000 | IRBST 6B10 | |
| 可變角度橢圓儀 | 材料膜厚及折射率分析 | VUV-VASE, Gen-II | IRBST 6A02 | |
| 奈米級雷射非接觸式3D表面量測儀 | 奈米級表面輪廓/粗糙度量測 | Keyence VK9710K S/N 2190011 | IRBST 4C01 | |
| 桌上型直寫曝光系統 | 多元件光阻圖樣製作 | Heidelberg uPG501 | IRBST B2C02 | |
| 微奈米製程 | 試片準備機一套 | 表面薄膜製程與蝕刻 | Gated Sted SKE104005 | IRBST 6A02 |
| 高解析高精密雙束聚焦離子系統 | 奈米元件結構製作 | FEI NanoLab660 | IRBST 4B19 | |
| 電感耦合電漿蝕刻機 | 奈米元件乾溼蝕刻 | OXFORD ICP65 | IRBST B2C02 |
本中心也會視情況進行設施升級及相關實驗室配置改善,
為了讓同仁安全地進行研究,中心對於各實驗室及設施都有相對應的安全規劃及管理。
| 類型 | 儀器 | 功能 | 廠牌 | 位置 |
|---|---|---|---|---|
| 高解析度顯微鏡 | 原子力顯微鏡 | 材料表面分析 | Bruker DM-CAFM | 陽明交通大學 田家炳光電中心 506室 |
| 快速雷射掃描共軛焦分光光譜顯微鏡 | 生物暨螢光樣品量測 | Leica TCS-SP5 | IRBST 4B20 | |
| 液相原子力顯微鏡 | 奈米材料或元件液態檢測 | JPK Nano Wizard II & III | IRBST B2C01 | |
| 顯微拉曼光譜儀 | 材料螢光及結晶特性分析 | Jobin Yvon HR800 | IRBST 6B08 | |
| 場發射高低真空高解析度掃描式電子顯微鏡 | 表面結構與元素分析 | Nova 200 NPE 44/D8187 | IRBST 4C05 | |
| 樣品分析 | X 光光電子光譜儀 | 表面與縱深元素分析 | ULVAC-PHI PHI-5000 Versaprobe | IRBST 4C05 |
| 掃描式離子顯微鏡 | 表面與縱深元素與分子分析 | ULVAC-PAI TRIFTV | IRBST 4C05 | |
| 皮秒時間相關單分子螢光顯微光譜儀 | 多通道的時間解析光譜系統 | PicoQuant Micro Time 2000 | IRBST 6B10 | |
| 可變角度橢圓儀 | 材料膜厚及折射率分析 | VUV-VASE, Gen-II | IRBST 6A02 | |
| 奈米級雷射非接觸式3D表面量測儀 | 奈米級表面輪廓/粗糙度量測 | Keyence VK9710K S/N 2190011 | IRBST 4C01 | |
| 桌上型直寫曝光系統 | 多元件光阻圖樣製作 | Heidelberg uPG501 | IRBST B2C02 | |
| 微奈米製程 | 試片準備機一套 | 表面薄膜製程與蝕刻 | Gated Sted SKE104005 | IRBST 6A02 |
| 高解析高精密雙束聚焦離子系統 | 奈米元件結構製作 | FEI NanoLab660 | IRBST 4B19 | |
| 電感耦合電漿蝕刻機 | 奈米元件乾溼蝕刻 | OXFORD ICP65 | IRBST B2C02 |
主要提供薄膜製程機台以協助本中心及本院同仁進行光電元件、量子元件、感測器及微流道等相關開發研究。

感應式耦合電漿蝕刻系統
Oxford ICP-RIE
- 薄膜蝕刻種類:非金屬
- 製程氣體:O2, CHF3
- 蝕刻真空度:1-10 mTorr
- 沈積時最低操作壓力:200-2000mTorr
- 電漿產生裝置:上電極:15V
下電極:-15V - 適用基板尺寸:4" wafer
- 使用費:1000/h

電子束蒸鍍系統
Ulvac E Beam Evaporator
(for oxide)
- 蒸鍍材料種類:氧化物
- 蒸鍍源:可同時容納4個鍍源材料
- 製程氣體:O2
- 最低真空能力:~10-7 torr
- 操作壓力:5X10-6 torr
- 最高壓力:3X10-5 torr
- 極限加熱溫度:150 ℃
- 旋轉速率:15 rpm
- 適用基板尺寸:4" wafer
- 使用費:800/h

電子束蒸鍍系統
Ulvac E Beam Evaporator
(for metal)
- 蒸鍍材料種類:金屬
- 蒸鍍源:可同時容納6個鍍源材料
- 最低真空能力:~10-7 torr
- 操作壓力:5X10-6 torr
- 最高壓力:3X10-5 torr
- 極限加熱溫度:150 ℃
- 旋轉速率:0-25 rpm
- 適用基板尺寸:4" wafer
- 使用費:800/h

熱蒸鍍系統
Ulvac Thermal Evaporator
- 蒸鍍材料種類:金屬、非金屬
- 蒸鍍源:可同時容納4個鍍源材料
2種材料同時共蒸鍍 - 極限壓力:~10-4 Pa
- 操作壓力:4X10-4 Pa(3X10-6 torr)
- 蒸鍍溫度:150 ℃
- 旋轉速率:non
- 適用基板尺寸:4" wafer
- 使用費:500/h

射頻/直流濺鍍系統
RF/DC Sputter
- 濺鍍材料種類:金屬、非金屬
- 蒸鍍源:2 DC-gun, 1 RF-gun
可同時1 DC 1 RF共濺鍍 - 靶材需求:3" target
- 製程氣體:Ar, O2
- 極限壓力:~10-6 torr
- 操作壓力:1-50 mTorr
- 旋轉速率:15 rpm
- 適用基板尺寸:4" wafer
- 使用費:500/h

直流濺鍍系統
DC Sputter
- 濺鍍材料種類:金屬
- 蒸鍍源:1 DC-gun/ 2 DC-gun
- 靶材需求:2"/3" target
- 製程氣體:Ar
- 極限壓力:~10-6 torr
- 操作壓力:1-50 mTorr
- 旋轉速率:
- 濺鍍溫度:non/700 ℃
- 適用基板尺寸:4" wafer
- 使用費:500/h

奈米壓印曝光機
Mask Aligner EVG620 NT
- 光源功率:
- 光源波長:
- 曝光強度:
- 適用基板尺寸:
- 使用費:1000/h

直寫機
Heidelberg direct writer
- 光源功率:70mW
- 光源波長:365nm
- 曝光強度:
- 適用基板尺寸:破片
2"-5"矽晶圓
2"-5"玻璃光罩 - 使用費:800/h